课件分享(SiC MOSFET栅可靠性相关-晏北)
- 2026-04-13 04:14:16
来源:晏北
一、链接:高漏压DGB实验SiC MOSFET之阈值电压漂移
1、2024年,开姆尼茨工业大学,主要内容,是SiC MOSFET器件HV-GSS实验的阈值电压漂移研究;
2、本文提出HV-GSS实验,在栅极开关应力基础上,施加高漏源电压,旨在研究高电场对沟道和栅氧可靠性的影响;
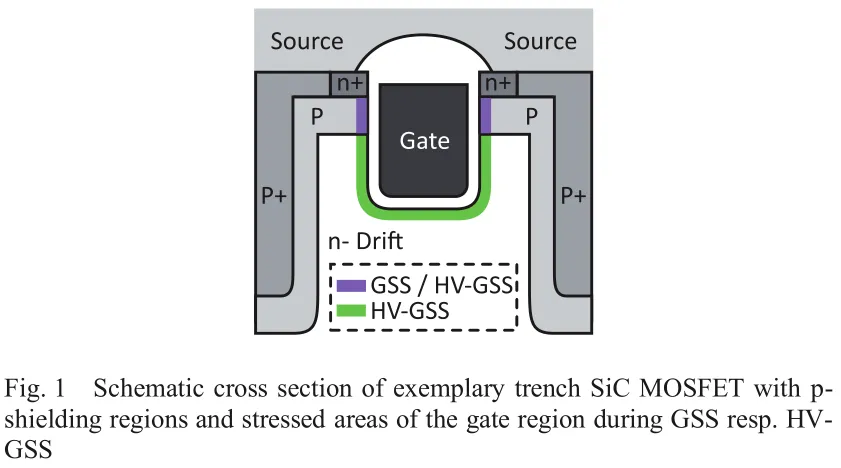
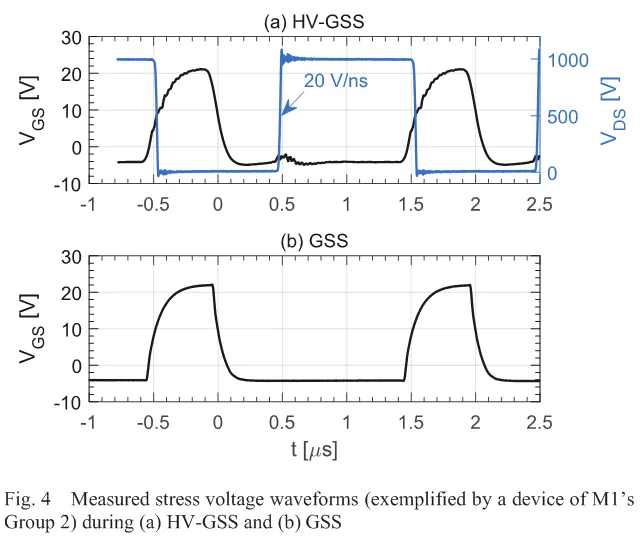
1、2022年的文章,来自九州产业大学,主要内容是SiC MOSFET器件BTI及TDDB可靠性研究;
2、本文对比了两款商用SiC MOSFET器件在偏压温度不稳定性(BTI)、经时介质击穿(TDDB)两方面的可靠性;
3、A的三只样品的tBD离散很大,B的tBD和QBD均表现出异常的温度依赖性,即在室温下击穿时间最长;

1、2024年的文章,来自成电,主要内容是富氮设计对SiC MOSFET抗辐照能力的影响;
2、本文通过不同栅氧工艺,在SiC MOSFET和MOS电容的栅氧化层中引入不同含量的氮元素,再进行辐照实验,以探究氮元素含量高低对器件抗辐射能力的影响;
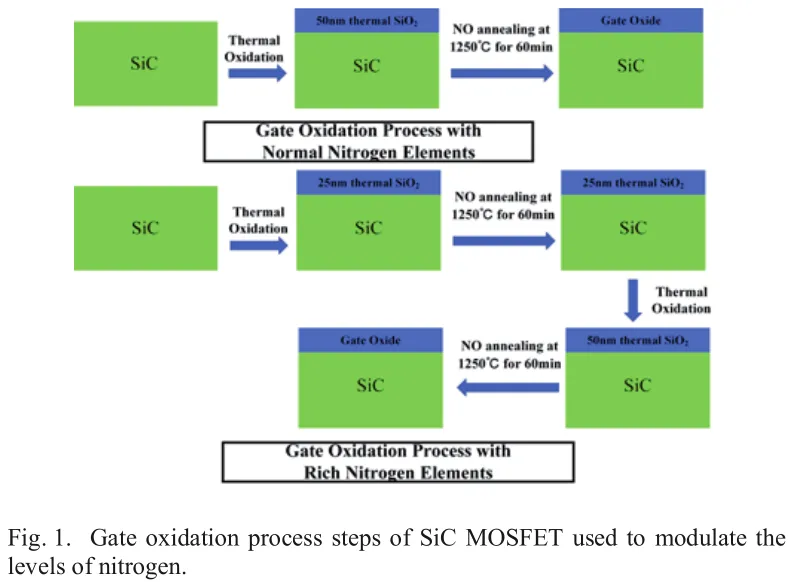
3、富氮设计不影响辐照前的栅氧化层寿命(辐照前不同氮含量器件的β值相近),但富氮设计加剧了辐照后栅氧寿命退化(辐照后样品β值显著增大)。富氮设计尽管可以降低Dᵢt,但也引入了空穴陷阱;
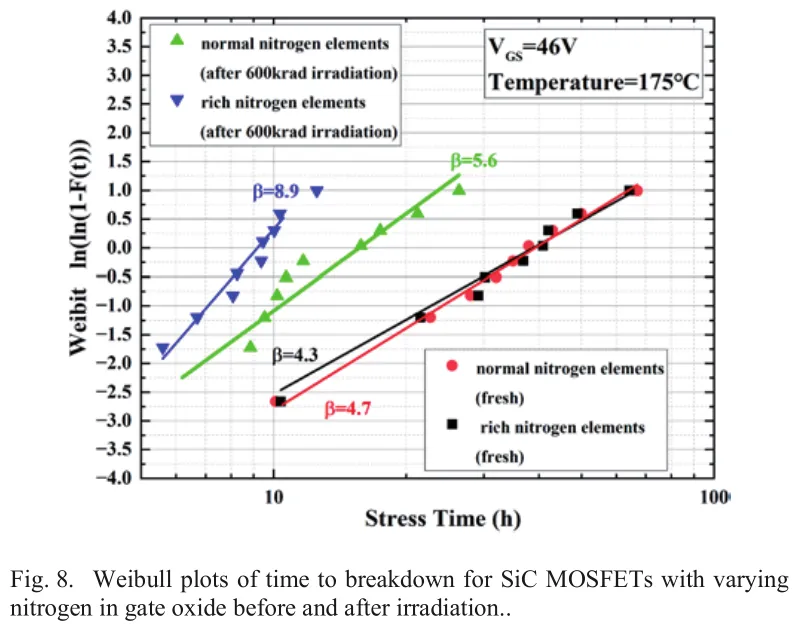
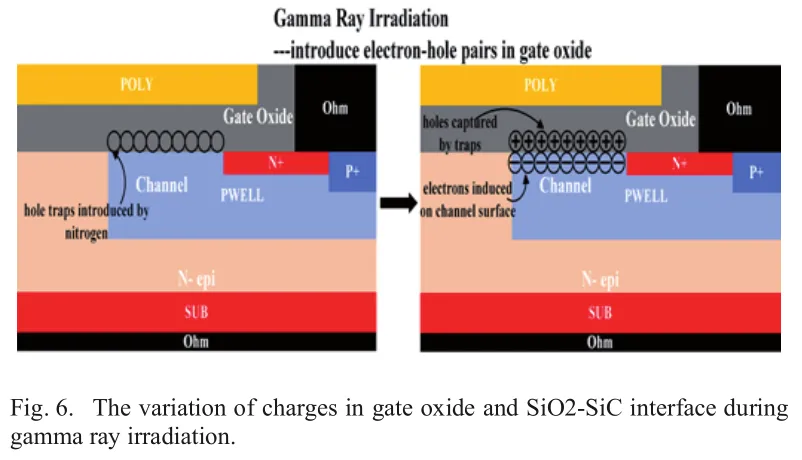
四、链接:SiC平面MOSFET栅氧可靠性及阈值电压不稳定性问题
1、2022年的文章,来自安森美,研究SiC 平面MOSFET的栅氧可靠性和阈值电压不稳定性;
2、高电场下栅氧化层的电学表征对SiC MOSFET芯片具有重要意义;动态栅偏(Dynamic Gate Bias,实验条件为:温度25℃、漏源电压0 V,-8 V / 20 V栅源电压应力,占空比50%)引起的SiC MOSFET参数漂移,主要表现为Vth和Rdon的增大;
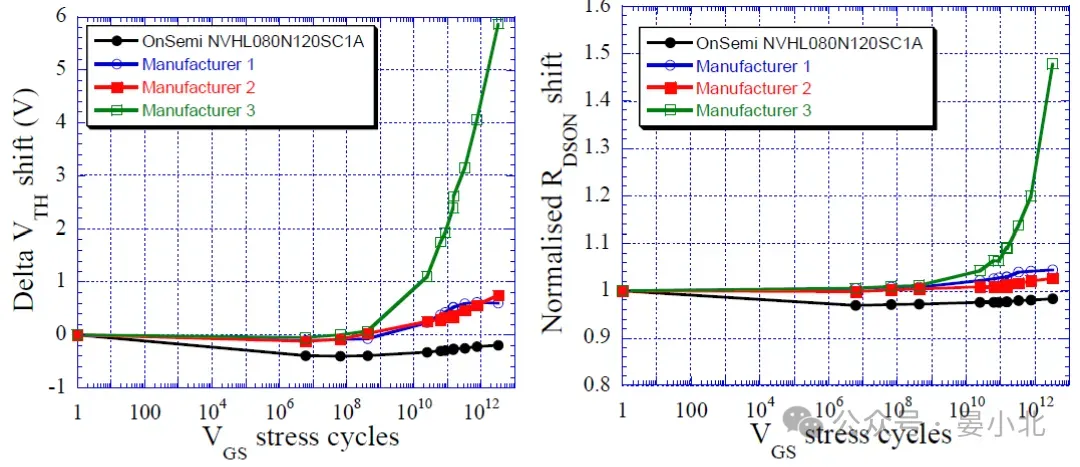
五、链接:负栅压下,SiC MOSFET阈值电压不稳定性机理
1、2025年的文章,来自北大,主要内容是负栅压下,SiC MOSFET阈值电压不稳定性之机理;
2、当体二极管导通时,大量空穴会从P阱注入JFET区,结合负栅压作用,这些空穴可能被驱至栅氧化层附近;这些热空穴导致MOS界面产生正电荷俘获,使缺陷产生,进而导致Vth负向漂移;
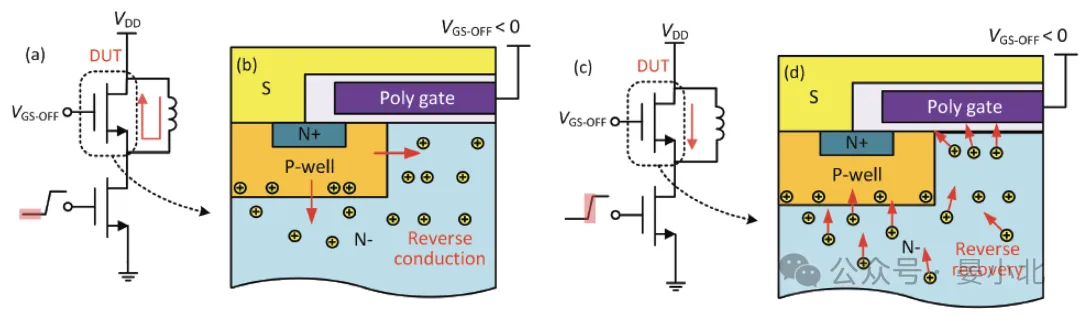
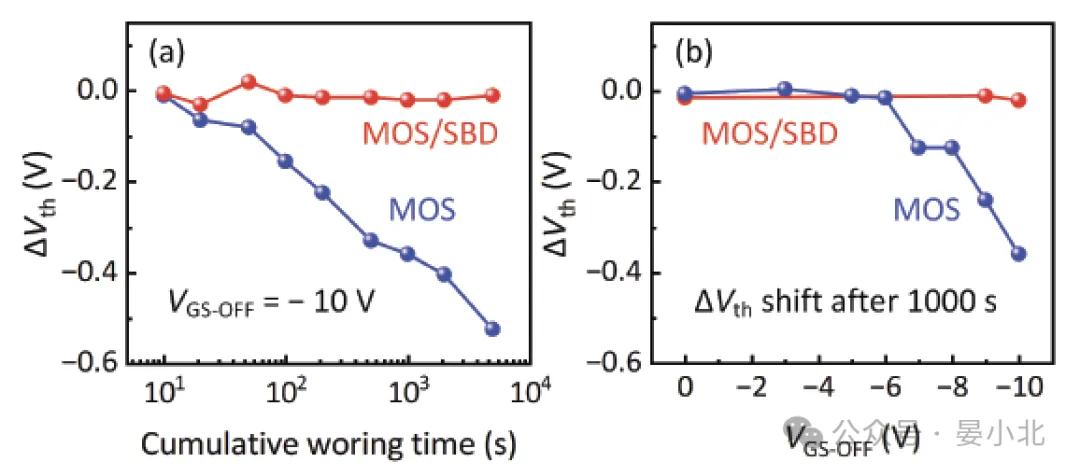
全文完。
原文见链接: https://pan.baidu.com/s/5EEFpnLY2a1_e29OKbCsNhQ
貌似还有几篇,不再一一罗列,仰望依旧!
