课件推送(雪崩应力下碳化硅MOSFET阈值电压漂移研究(论文解析)-发功不发热)
- 2026-04-07 00:41:03
来源:发功不发热(这名起的,深见功底啊!)

链接:雪崩应力下碳化硅MOSFET阈值电压漂移研究(论文解析)
关键信息摘录如下:
1、现有sic mosfet器件采用老化筛选(HTRB/±HTGB,小时级)测试,剔除早期失效;
2、本文的初衷为探索一种新的测试方法替代老化筛选(成本高,效率低);
3、本文提出了一种可量化、重复性强的雪崩应力后的阈值漂移测试方法;开发一台测试系统,可实现5000次以上的连续雪崩测试,并同时完成雪崩前后阈值电压测试;

4、测试结果:
4.1、单次雪崩测试时序如图1:
初始VTH测量(t0-t1):系统首先测量雪崩前的阈值电压,为VTH-1;
雪崩应力施加(t2-t4):随后,系统对器件施加一个雪崩应力脉冲;
通过精确控制脉冲宽度(tpulse = t3-t2),可以实现对雪崩电流和能量的精确控制;
低延迟测量(t4-t5):雪崩结束后,系统仅延迟数毫秒(t4-t5);
雪崩后VTH测量(t5-t6):紧接着进行第二次VTH测量,记为VTH-2;
自动计算漂移量:系统自动计算并记录阈值电压漂移量 ΔVTH=VTH-2- VTH-1;
重复雪崩测试时序如图2:在单次雪崩基础上增加了雪崩测试过程的循环。

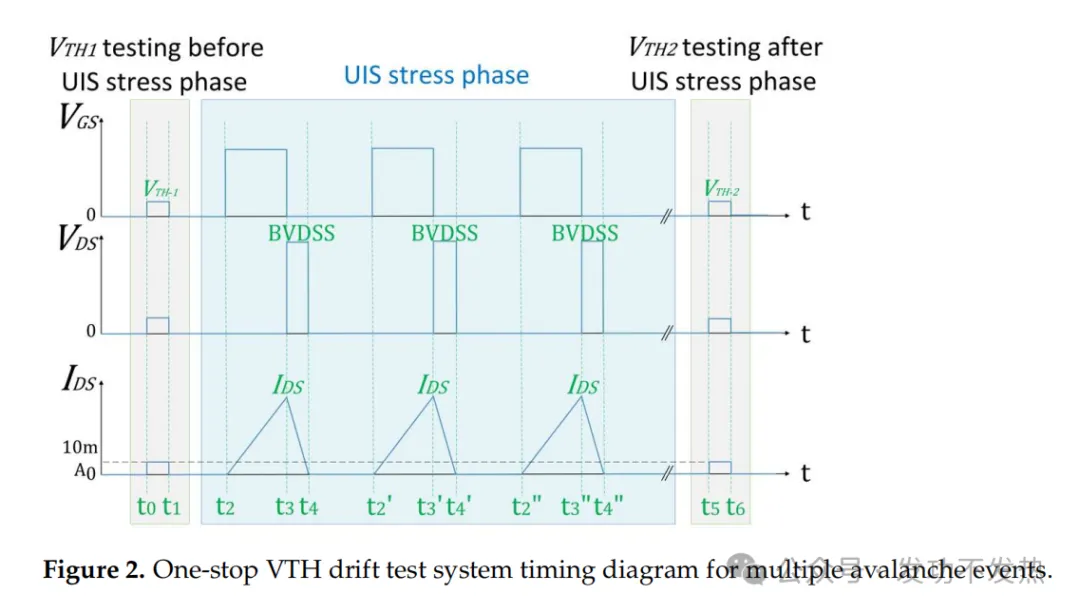
4.2、雪崩测试条件:初始VDS=50V,储能电感L=100μH,栅极开启电压VGS-ON=18V,雪崩电流约10.8 A,不同栅极关断电压(VGSOFF);
4.3、测试结果:
漂移方向:当 VGSOFF = 0V 时,ΔVTH出现正向漂移(约+0.11 V),当 VGSOFF为负压时,ΔVTH出现负向漂移;
饱和现象:随着VGSOFF负压增大,负向漂移的绝对值增大,并在VGSOFF ≤ -6 V时趋于饱和,约为-0.226 V;
恢复特性:雪崩应力移除后,ΔVTH会随着时间推移逐渐恢复至零。初始恢复速度较快,后续变慢;
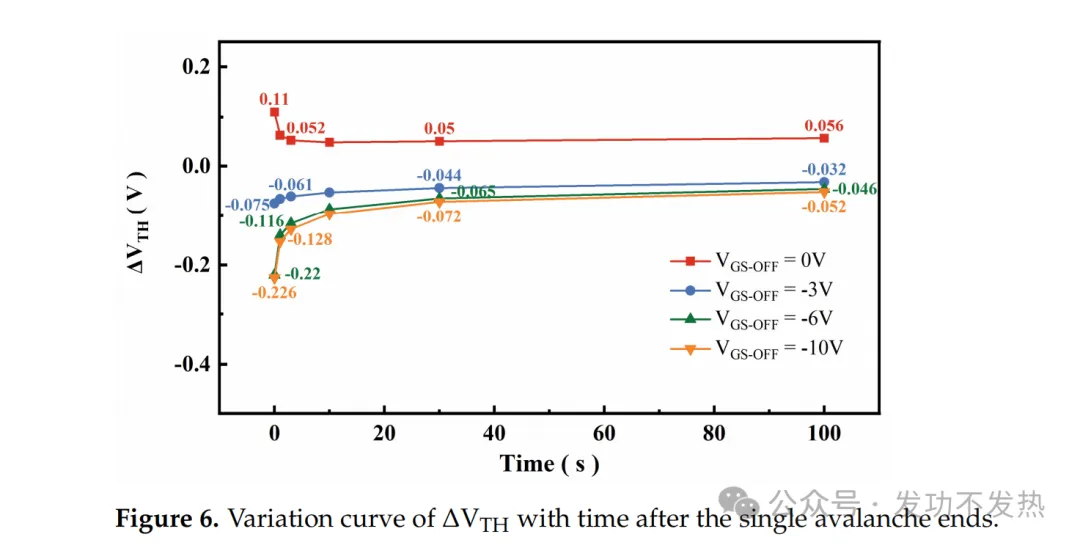
5、作者向行业输出的一台全新测试理念的设备,暂停留在科学研究的初级阶段;但作者相信高效的自动测试(Automatic Test Equipment,ATE)筛代替费钱/时低效的老化筛是未来趋势;
推荐理由:许久没见发功兄的大作了,抓紧翻起来;这篇竟然是11月份的,笔者看来还是偷懒了,抓紧把债还一下,隔年了!话说老化筛确实耗时费力,有没有更好的手段呢?本文提出了一种方案,用雪崩筛,是不是个好法子呢,抛砖引玉哈!!!推荐大家伙一起深究,深追追更!!!

